前沿逻辑电路技术的尺寸缩减给互连堆层的尺寸和工艺整合带来了重大挑战,尤其是中道(MOL)结构。金属间距的减小导致电容增大,而金属宽度和高度的减小则增加了电阻。这种对延迟的RC寄生贡献可以抵消或大大降低改进晶体管驱动电流的获得的好处。为了缓解电阻增加的趋势,半导体制造商正在探索电阻率比铜更低的替代金属。
在DTCO(Design Technology Co-Optimization)的背景下,新的互连金属不仅能够降低MOL中的寄生负载,而且有助于集成新的尺寸缩减方案,如包埋式供电线轨(buried power rails),此时低电阻率导线对于缓解配电网络中的互连电阻损耗(IR-drop)至关重要。
本文综述了QuantumATK原子尺度模拟方案 在缩减互连堆层尺寸研究中的应用。QuantumATK能够使用严格的密度泛函理论(DFT)和非平衡格林函数(NEGF)方法计算金属的电子输运和电阻率。从模拟中得到的结果和见解让技术人员能够更有效地选择替代金属并集成到先进的逻辑和记忆电路工艺中。
典型的互连堆层如图1所示。
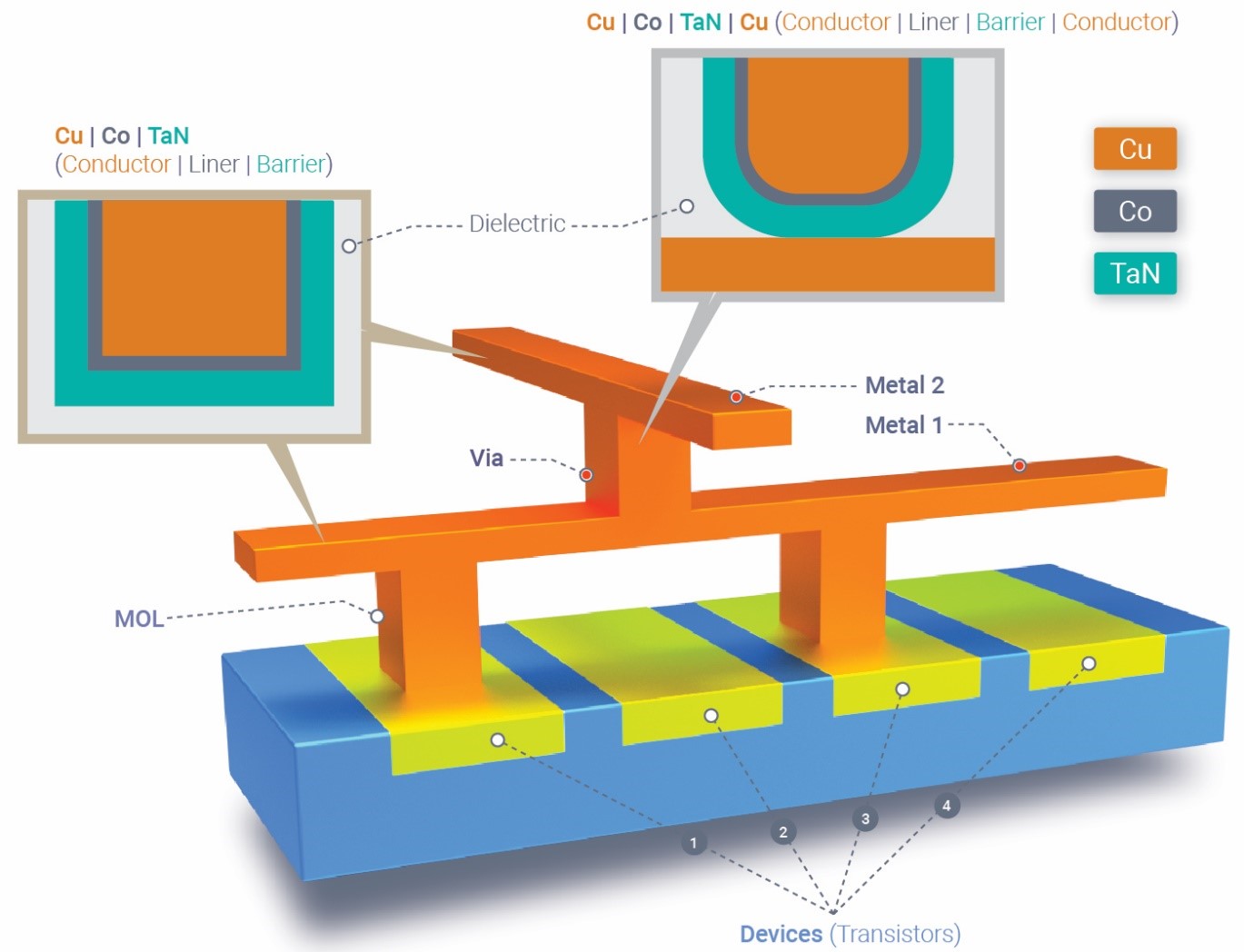
图1:典型的互连堆层
铜(Cu)的封装结构包括一层衬垫层,该衬垫层可促进金属的粘合;还包括一个阻挡层(通常为TaN),该阻挡层可防止Cu扩散到周围的电介质中,并阻止其他物质(如O2、OH–和H2O)进入互连。由于表面、缺陷和晶界的电子散射增加,铜的电阻率在与衬垫层和阻挡层的界面附近增大。随着线宽的减小,金属导电率的这种表面退化影响增大(如图2所示),并开始主导导线或通路的整体有效电阻率。此外,为防止电迁移,阻挡层材料的厚度必须保持大体恒定;而线宽减小导致更大比例的导线横截面由电阻比铜高的阻挡层材料组成,这也进一步加剧了问题。
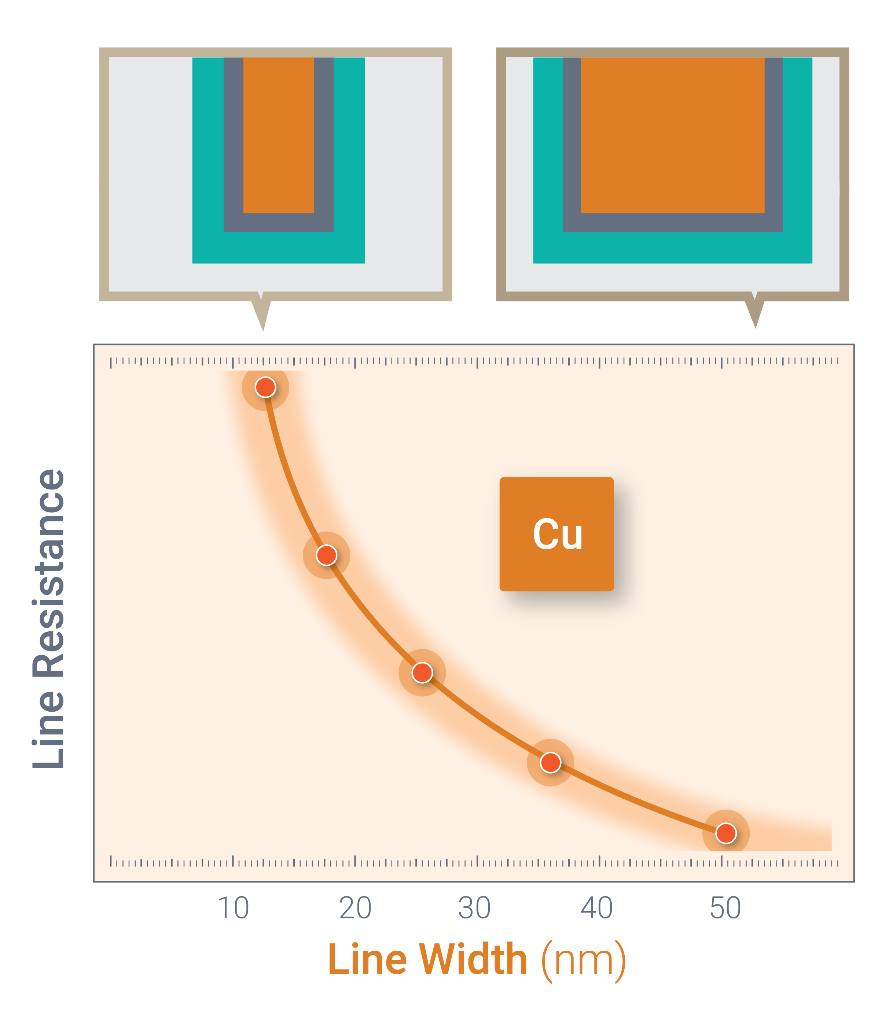
图2:由于线宽减小而导致的金属(Cu)导电性降低
正如本文关注的GlobalFoundries(GF)和IBM在发表论文中所强调的那样,使用QuantumATK进行原子水平模拟在描述不同散射效应对电阻的影响以及寻找降低电阻的途径方面具有极其重要的意义。
使用密度泛函理论(DFT)方法获得金属纳米线的电子结构(如态密度和结合能),可以评价其结构完整性和抗电迁移能力。利用QuantumATK中具有非平衡格林函数(NEGF)的DFT模块进行电子输运模拟,获得各种尺寸和取向纳米线的电流和热流、电阻/电阻率以及不同衬垫层和阻挡层材料界面的垂直电阻。DFT+NEGF还可以用于对晶界上各种缺陷和散射产生的电阻进行估计,并获得晶界反射系数。结果表明,QuantumATK预测的电阻率趋势和晶界反射系数与实验结果相当一致。QuantumATK还可以用来分析阻挡层材料。进行DFT+NEB(nudged elastic band,一种过渡态搜索方法)计算可以获得缺陷的形成能量和活化势垒,随后用于Sentaurus过程动力学蒙特卡罗模拟,可以估计为避免金属离子扩散到介电层所需的阻挡层金属厚度。
这些方法能够对尺寸缩减后电阻比铜小的金属线材料、导体|衬垫层|阻挡层|导体界面的通路电阻较小的金属线材料进行系统的筛选和表征,并找到具有高内聚能的金属,从而避免使用扩散阻挡层。作者对作为铜替代品的各种金属(铂、铑、铱、钯、铝、钌)进行了研究并得出了一些结论。与铜[1]相比,铝由于晶界(GB)散射大、垂直通路电阻大、电迁移率大而不适合作为铜的替代导体。Pt、Rh和Ir纳米线在内聚能(即抗电迁移)方面表现出优越的性能,并且可以在无扩散阻挡层的情况下使用[2];然而,铜还是比这些金属更优越,因为铜的电阻比这些金属小(GB散射小)。由于不需要扩散阻挡层,Ru是一种很有前途的选择。作者还研究了表面缺陷造成的Ru的表面退化以及Ru/衬垫层界面的GB散射和电阻[3]。
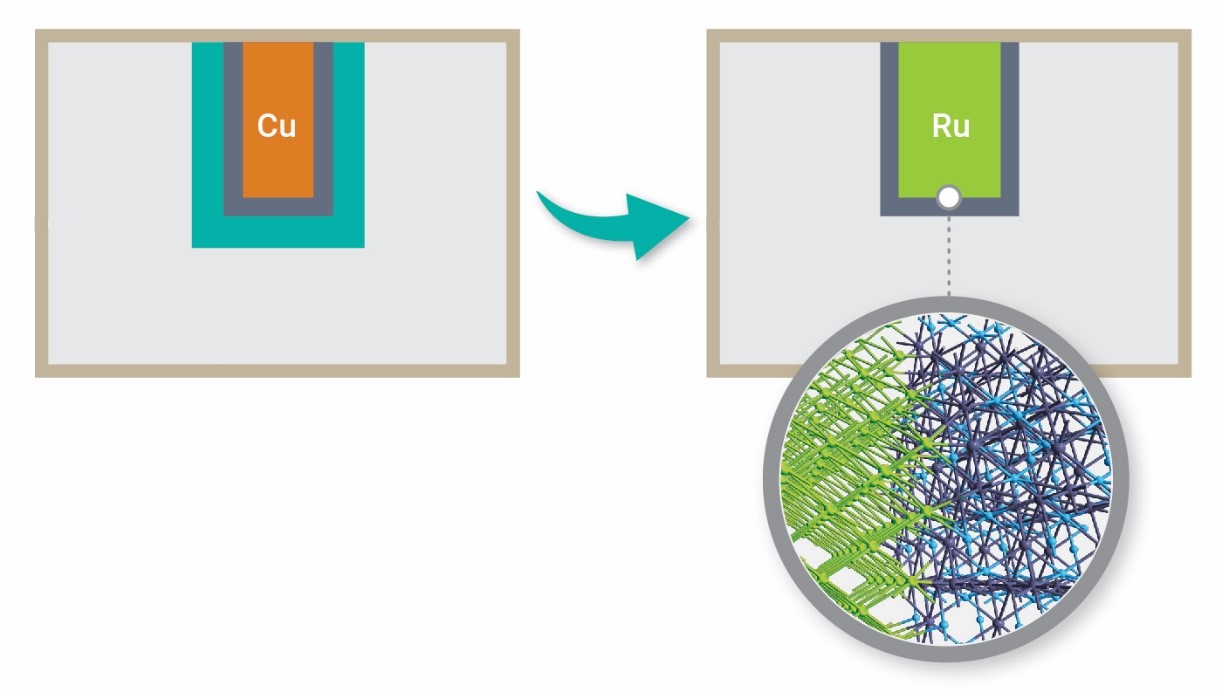
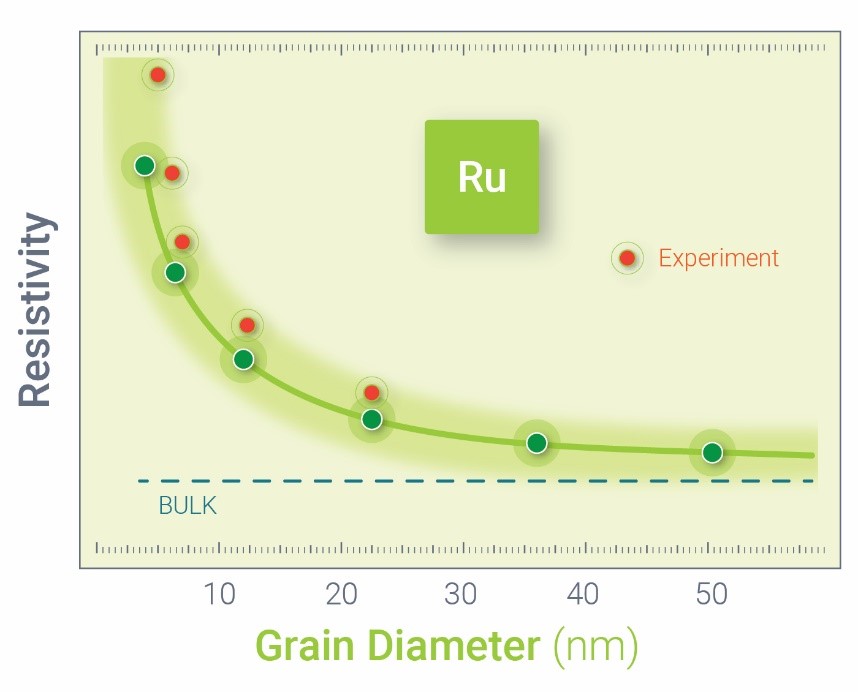
图3: Ru作为互连堆层的新导体金属的研究:Ru电阻率与晶粒直径的函数关系
通过改变衬垫层和阻挡层材料来降低电阻是缩小互连堆层尺寸的另一种策略。计算表明,TiN是最适合Ru互连的衬垫层材料(与Ti或TaN相比)[3]。如图4所示,铜导体的阻挡层从TaN变为Ta会导致通过通路结构的垂直电阻显著降低,无论是带有Co还是Ru的衬垫层情况。这与多尺度研究一致,多尺度研究预测通过将铜导体的扩散阻挡层从TaN到Ta,通路电阻可以减少约26%,这相当于可以使3纳米技术节点的器件性能增强2%[5]。重要的是,阻挡层(Ta->TaO,Ta2O5)和衬垫层(Ru-> RuO2)材料的氧化可进一步显著增加垂直电阻,根据氧化程度和金属与金属接触面积的不同,其变化幅度可达到一个数量级[6]。
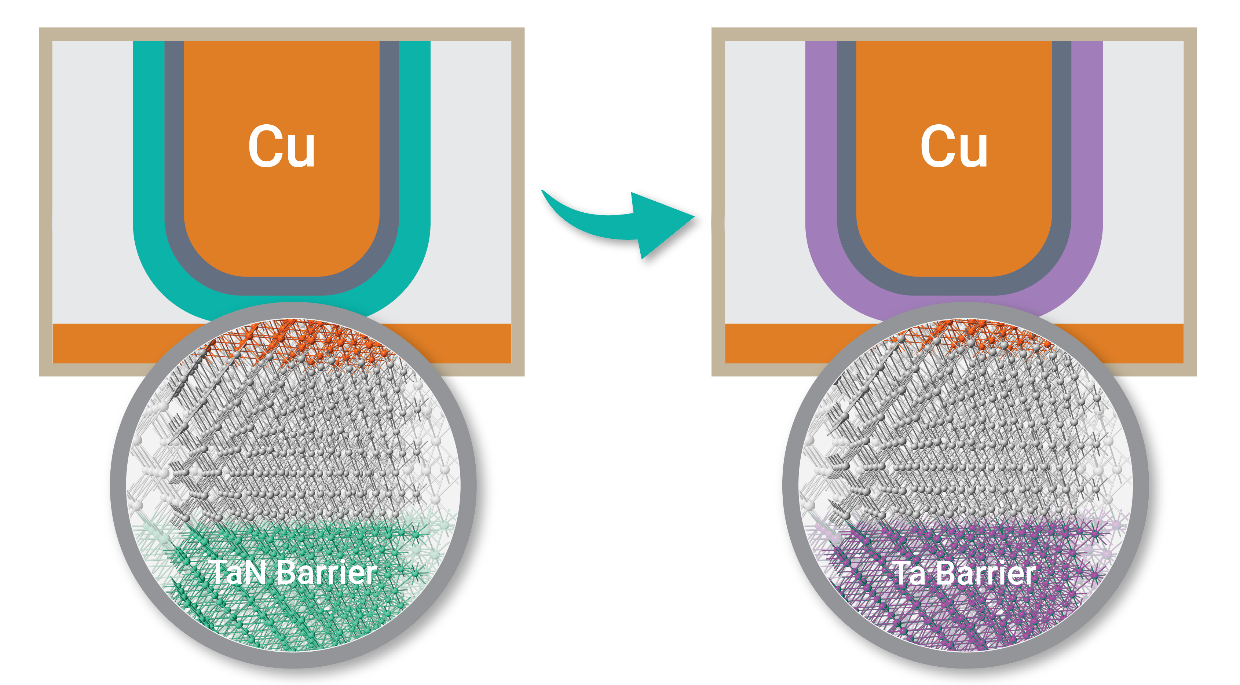
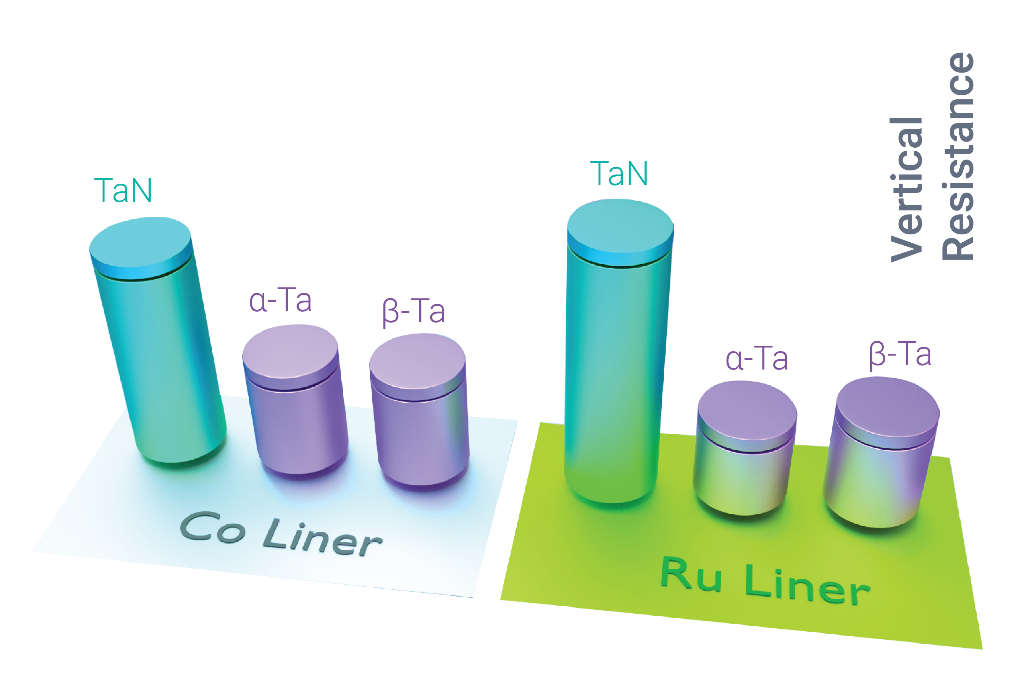
图4:互连堆层不同衬垫层材料(Co和Ru)和阻挡层材料(TaN和Ta)的研究:沿通路结构的垂直电阻
了解防止导体金属在互连堆层中扩散所需的阻挡层厚度也非常重要,因为这可以筛选阻挡层金属材料,使其在厚度较小时工作良好,从而为主要金属导体留出更多空间。一项将QuantumATK作为多尺度模拟方法一部分的研究确定了防止互连内Co扩散的TiN层的临界厚度为3纳米[7]。
虽然这一领域的大部分工作都集中在评估通路电阻上,但降低热阻同样重要。GlobalFoundries使用QuantumATK计算了块体材料Cu和Cu/TaN/Co/Cu界面的热流。结果表明,热流与电流一样受到界面散射的强烈影响[8]。用QuantumATK得到的结果可以用于大规模有限元模拟,以进一步模拟互连中的自发热。
未来,我们预计原子尺度模拟方法可以应用于更复杂的金属和材料(例如多相化合物和碳纳米管)的研究,因为半导体工业要继续寻找途径来减少先进工艺节点处上互连寄生效应的影响。
参考文献
- T. Zhou, N. A. Lanzillo, P. Bhosale, D. Gall, and R. Quon, “A first-principles analysis of ballistic conductance, grain boundary scattering and vertical resistance in aluminum interconnects”, AIP Adv. 8, 055127 (2018).
- N. A. Lanzillo, “Ab initio evaluation of electron transport properties of Pt, Rh, Ir, and Pd nanowires for advanced interconnect applications”, J. App. Phys. 121, 175104 (2017).
- H. Dixit, J. Cho and F. Benistant, “First-principles evaluation of resistance contributions in Ruthenium interconnects for advanced technology nodes”, SISPAD 2018.
- N. A. Lanzillo, O. D. Restrepo, P. S. Bhosale. E. Cruz-Silva, C.-C. Yang, B. Y. Kim, T. Spooner. T. Standaert, C. Child, G.Bonilla. and K. V. R. M. Murali, “Electron scattering at interfaces in nano-scale vertical interconnects: A combined experimental and ab initio study”, App. Phys. Lett. 112, 163107 (2018).
- N. A. Lanzillo, K. Motoyama, T. Hook, and L. Clevenger, “Impact of line and via resistance on device performance at the 5nm gate all around node and beyond”, IITC 2018.
- N. A. Lanzillo, B. D. Briggs, R. R. Robison, T. Standaert, C. Lavoie, “Electron transport across Cu/Ta(O)/Ru(O)/Cu interfaces in advanced vertical interconnects”, Comp. Mat. Sci. 158, 398 (2019).
- H. Dixit, A. Konar, R. Pandey, and T. Ethirajan, “How thin barrier metal can be used to present Co diffusion in the modern integrated circuits?”, J. Phys. D: App. Phys. 50, 455103 (2017).
- D. Singh, O. D. Restrepo, P. P. Manik, N. R. Manvilla, H. Zhang, P. Paliwoda, S. Pinkett, Y. Deng, E. Cruz Silva, J. B. Johnson, M. Bajaj, S. Furkay, Z. Chbili, A. Kerber, C. Christiansen, S. Narasimha, E. Maciejewski, S. Samavedam, C.-H. Lin, “Bottom-up methodology for predictive simulations of delf-heating in aggressively scaled process technologies”, IRPS 2018.
